БГА пайка что это?
Горячий воздух или ИК излучение?
Вся современная электроника, и ее производство основано микросхемах. Вся вычислительная техника построена на чипах, выполненных в корпусах типа BGA.
Что вообще такое BGA?
BGA: Ball Grid Array — корпус PGA, в котором, вместо контактов штырькового типа используются шарики припоя. Такой тип микросхем предназначен для поверхностного монтажа. Распространен в мобильных процессорах, чипсетах, современных графических процессорах видеокарт компьютеров и ноутбуков. Корпуса BGA так же существуют в нескольких вариантах (видах).
Обзор BGA ИК Станций за 2010 — 2011 год
Итак, выводы этого типа микросхем имеют форму шариков и расположены снизу корпуса, благодаря чему, можно увеличить плотность монтажа (количество размещаемых элементов) на печатной плате. Работа с такими микросхемами требует особого подхода, сейчас поймете почему. Говоря о первичном монтаже (при производстве плат с такими чипами) должно соблюдаться точное совмещение контактов микросхемы с контактной площадкой на плате и равномерное запаивание всех контактов, путем равномерного прогрева. А в случае выпаивания (демонтажа) микросхемы, что опять же усложнено труднодоступностью выводов, нужно равномерный нагрев для отпаивания всех контактов. В обоих случаях должен быть четкий контроль качества процесса пайки.
Руками сделать такую работу теоретически не возможно. Но на практике ремонтники умудряются паять их даже на бытовой газовой плите… Для удобства пайки и демонтажа микросхем типа BGA нужно специальное оборудование благодаря которому можно максимально оптимизировать весь процесс работы с монтажом и демонтажем BGA микросхем. Также все более популярной стала технология пайки с использованием без свинцовых припоев, а в этом случае вопрос соблюдения технологии качественной пайки занимает первое место.
В чем разница пайки свинцовой и бессвинцовой?
При бессвинцовой пайке температура нагрева требуется выше на 30-40 градусов, в отличии от традиционной пайки с использованиес свинец-содержащих припоев. И по этому максимально допустимая рабочая температура для компонентов поверхностного монтажа (SMD и BGA) находится в диапазоне от 250 до 260 градусов.
Основная задача в процессе пайки это аккуратное и быстрое выпаивание элемента без повреждения соседних элементов критичных к перегреву.
Предпочтителен инструмент, который сочетает в себе «низкую» температуру и высокую теплопередачу. При соблюдении всех условий демонтажа в большинстве случаев, невредимой сохраняется и отпаянная микросхема, это особенно полезно, в тех случаях, когда предположение о том, что она являлась причиной неисправности, опровергается.
Теперь о том какие существуют способы нагрева микросхем для пайки и демонтажа.
В локальной пайке и выпаиванию BGA чипов есть два варианта:
Соответственно основанные на этих способах существуют и используются различные типы паяльных станций.
Рассмотрим сначала термо воздушные паяльные станции.
Термо-воздушные станции – устройство бесконтактной пайки, для нагрева паяемых компонентов используется открытый поток нагретого воздуха, который сфокусирован специальным соплом.




Грубо говоря это фен. Так как принцип его работы аналогичен работе обычного фена для высушивания волос. Разница лишь в температуре потока воздуха исходящего из сопла фена. Температура воздуха на выходе такой паяльной станции регулируется от 100 до 480 градусов Цельсия. Еще имеется возможность коррекции воздушного потока.
Термовоздушные станции пайки делятся на 2 способа подачи воздушного потока:
В компрессорных, воздух подается работой диафрагменного компрессора расположенного в корпусе станции.
У турбинных, же в блоке термофена встроен маленький почти бесшумный электрический двигатель с крыльчаткой, который создает нужную величину воздушного потока.
Преимущества таких станций в их компактности, ими можно работать на рабочих местах малой площади.
Особенностью BGA-компонентов является расположение контактов, их выводы, представляющие из себя контактные площадки с шариками припоя, находящиеся под корпусом устанавливаемого на плату компонента, эти контакты недоступны для традиционных паяльных устройств. Поэтому напайка этих компонентов осуществляется сквозным прогревом корпуса.
Разумеется, верхняя часть корпуса микросхему прогревается быстрее, чем шариковые выводы, так как они контактируют с платой, это и затрудняет их нагревание.
Бесконтактная пайка BGA-компонентов на поверхность печатной платы потоком горячего воздуха — процесс эмпирический. Температура воздуха места пайки регулируется двумя основными параметрами: выставленной температурой нагревателя, через который проходит воздух, и скоростью воздушного потока. Интересный факт в том что реальная температура потока воздуха из сопла выставляется приблизительно.
Расстояние от сопла до компонента припаиваемого к плате тоже весьма критично. Если Увеличение скорости потока воздуха снижает рассеивание воздуха на выходе из сопла, но требует повышения температуры нагревателя, это понятно, ведь высокая скорость прохождения потока воздуха через нагревательный элемент снижает разогрев воздуха, иными словами он просто не успевает нагреться до нужной температуры.
Из за неточности размеров сопел, особенно в головках для микросхем с большим количеством контактов, подвод тепла к месту пайки происходит не равномерный. Что ведет к увеличению опасности «термотравмы» компонента и печатных проводников на плате.
Различные конструкции паяльных станций для пайки и демонтажа горячим воздухом предполагают различные степени и способы контроля параметров термо инструментов — температуры воздуха, нагнетаемого в сопло фена и его количества, подаваемого в единицу времени.
У самых примитивных моделей нет обратной связи и можно лишь визуально наблюдать за поведением припоя в рабочем пространстве, и иметь представление о тепловой картине места пайки, глядя на положение регуляторов нагревательного прибора. Зато эти стации достаточно дешевые, спектр их применения ограничен. Основное их предназначение это демонтажные операции, в которых не требуется идеально точного соблюдения термо режима. Станции имеющие четкий контроль и стабилизацию температуры самые дорогие в своем классе. Они также имеют индикацию в реальном времени температуры воздуха на выходе фена, имеют индикатор давления воздушного потока.
Теперь рассмотрим следующий вид станций это инфракрасные паяльные станции.
Они основаны на излучении инфракрасных волн от нагревательного элемента, вместо потока горячего воздуха.



Механизмом генерации тепла, используемым ИК станциях, является излучение. ИК-волны диапазона 2-8мкм, лучшее в смысле соотношения отражаемой и поглощаемой тепловой энергии: видимые ИК волны не пригожи для процесса пайки, так как они перегревают темные поверхностей и не прогревают блестящие выводы микросхем.
На таких станциях можно выполнять операции пайки и демонтажа компонентов, имеющих размеры от 10мм до 60мм. Среди них микросхемы в корпусах различного типа BGA, CSP, PGA, SOIC, QFP, PLC. Можно также ее использовать для локальной пайки группы компонентов на ограниченном участке монтажной платы. Размеры прямоугольной зоны нагрева задаются органами регулировки окна верхнего излучателя.
В принципе, оба способа: термовоздушный и ИК, имеют корни из технологий групповой пайки в печах плавления. Но при задачах ремонтной (локальной) пайки совершенно иная потребность. Если в случае с печью, которая должна обеспечить равномерный нагрев по всей поверхности платы, то ремонтная станция — только в отдельной области платы, при этом не подвергать соседние элементы термическому воздействию.
Лучшим решением для локальных ремонтных работ особенно с BGA, предпочтительна именно инфракрасная технология.
В местах первичного контакта струи воздуха с плоскостью, температура выше, чем зонах оттока «отработавшего» воздуха. Чтобы снижать завихрения, приходится замедлять поток воздуха, но это приводит к недостаточному переносу тепла: ведь неподвижный воздух является теплоизолятором!
Достаточно рассмотреть эти термограммы, это пятна нагрева плоскости корпуса BGA.



Горячий воздух сопло2 Горячий воздух сопло1 ИК-излучатели
ИК излучение имеет большее преимущество перед воздухом, так как это единственный механизм теплопередачи, который позволяет передавать тепловую энергию по всей площади монтируемой микросхемы.
Так как равномерный прогрев больших корпусов BGA воздушным потоком крайне затруднителен, для проведения ремонтной пайки, рекомендуется использовать именно инфракрасные станции.
Главные достоинства технологии инфракрасной пайки:
• равномерный локальный нагрева (самый критичный фактор для BGA)
• отсутствие вероятности сдуть с печатной платы демонтируемый компонент
• нет потребности в приобретении сменных профильных насадок для фена под определенные размеры чипов
• возможна работа компонентами сложного профиля
У многих возникает вопрос: не происходит ли перегрев инфракрасным излучением темных поверхностей BGA микросхем? и хватает ли его тепловой энергии для оплавления припоя светлых выводов микросхем QFP? Нелепо утверждать, что нет разницы в нагреве. Разница есть, но при длине волны 2…8 мкм которая является минимальной в инфра красном — диапазоне, за счет чего и обеспечивается достаточная для качественной пайки равномерность нагрева поверхностей имеющей различную отражающую способность.
Какую выбрать паяльную станцию? Термо воздушную или инфра красную?
Все зависит от Ваших потребностей, что Вам нужно на ней делать. Ремонтировать материнские платы от ноутбуков, или компьютерные материнские платы, а может платы мобильных телефонов. В общем, с платами от мобильников все имеющиеся на рынке паяльные станции от китайских производителей с разной степенью, но справляются. Станции одной ценовой категории, почти идентичны и нелепо обсуждать какая из них лучше, какая хуже. Ремонт материнских плат гораздо удобней производить на инфракрасной паяльной станции. Потому что на таких платах стоят микросхемы больших размеров требующих значительного и главное равномерного прогрева по всей площади.
Соответственно цена инфракрасных станций в разы дороже по сравнению, с термовоздушными.
Как перепаять BGA микросхему
В ремонтах телефонов бывает очень много различных поломок, связанных именно с микросхемами. Эти BGA микросхемы могут отвечать за какие-либо определенные функции в телефоне. Например, одна микросхема может отвечать за питание, другая – за блютуз, третья – за сеть и тд. Иногда, при падении телефона, шарики микросхемы BGA отходят от платы телефона и у нас получается, что цепь разорвана, следовательно – телефон теряет некоторые функции. Для того, чтобы поправить это дело, ремонтники или прогревают микросхему, чтобы припойный шарик расплавился и опять “схватился” с контактной площадкой на плате телефона или полностью демонтируют микросхему и “накатывают” новые шарики с помощью трафарета. Процесс накатывания шаров на микросхему BGA называется реболлинг. На российских просторах этот термин не прижился и у нас это называют просто “перекаткой”.
Подопытным кроликом у нас будет плата мобильного телефона.
Для того, чтобы легче было отпаивать “вот эти черные квадратики” на плате, мы воспользуемся инфракрасным преднагревателем или в народе “нижним подогревом”. Ставим на нем температуру 200 градусов по Цельсию и идем пить чай. После 5-7 минут приступаем парировать нашего пациента.
Остановимся на BGA микросхеме, которая попроще.
Теперь нам надо подготовить инструменты и химию для пайки. Нам никак не обойтись без трафаретов для различных BGA микросхем. Те, кто серьезно занимается ремонтами телефонов и компьютерной техники, знают, насколько это важная вещь. На фото ниже предоставлен весь набор трафаретов для мастера по ремонту мобильных телефонов.
Трафареты используются для “накатывания” новых шаров на подготовленные BGA микросхемы. Есть универсальные трафареты, то есть под любые BGA микросхемы. А есть также и специализированные трафареты под каждую микросхему. В самом верху на фото мы видим специализированные трафареты. Внизу слева – универсальные. Если правильно подобрать шаг на микросхеме, то можно спокойно накатать шары на любой из них.
Для того, чтобы сделать реболлинг BGA микросхемы, нам нужны также вот такие простые инструменты и расходные материалы:
Здесь всем вам знакомый Flux-off. Подробнее про него и другую химию можно прочесть в статье Химия для электронщика. Flus Plus, паяльная паста Solder Plus (серая масса в шприце с синим колпачком) считается самой лучшей паяльной пастой в отличие от других паст. Шарики с ней получаются как заводские. Цена на такую пасту дорогая, но она того стоит. Ну, и конечно, среди всего прочего барахла есть также ценники (покупайте, чтобы они были очень липкие) и простая зубная щетка. Все эти инструменты нам понадобятся, чтобы сделать реболлинг простой BGA микросхеме.
Для того, чтобы не спалить элементы, расположенные рядом, мы их закроем термоскотчем.
Смазываем обильно микросхему по периметру флюсом FlusPlus
И начинаем прогревать феном по всей площади нашу BGA
Вот здесь и наступает самый ответственный момент при отпаивании такой микросхемы. Старайтесь греть на воздушном потоке чуть меньше среднего значения. Температуру повышайте буквально по пару градусов. Не отпаивается? Добавьте немного жару, и главное НЕ ТОРОПИТЕСЬ! Минута, две, три… не отпаивается… добавляем жару.
Некоторые ремонтники любят трепаться “хахаха, я отпаиваю BGАшку за считанные секунды!”. Отпаивают то они отпаивают, но при этом не понимают, какой стресс получает отпаиваемый элемент и печатная плата, не говоря уже о близлежащих элементах. Повторю еще раз, НЕ ТОРОПИТЕСЬ, ТРЕНИРУЙТЕСЬ НА ТРУПАХ. НЕ ТОРОПИТЕСЬ срывать не отпаянную микросхему, это вам выйдет боком, потому как оборвете все пятаки под микросхемой! Пользуйтесь специальными устройствами для поднятия микросхем. Их я находил на Али по этой ссылке.
И вот мы греем феном нашу микросхему
и заодно проверяем ее с помощью экстрактора для микросхем. Про него я писал еще в этой статье.
Готовая к поднятию микросхема должна “плавать” на расплавленных шариках, ну скажем… как кусочек мяса на холодце. Притрагиваемся легонько к микросхеме. Если она двигается и опять становится на свое место, то аккуратненько ее поднимаем с помощью усиков (на фото выше), Если же у вас такого устройства нет, то можно и пинцетом. Но будьте предельно осторожны! Не прикладывайте силу!
В настоящее время существуют также вакуумные пинцеты для микросхем такого рода. Есть ручные вакуумные пинцеты, принцип действия у которых такой же, как и у Оловоотсоса

а есть также и электрические

У меня был ручной пинцет. Честно говоря, та еще какашка. Закоренелые ремонтники используют электрический вакуумник. Стоит только приблизить такой пинцет к микросхеме BGA, которая уже “плавает” на расплавленных шариках припоя, как он тут же ее подхватывает своей липучкой.
По отзывам, электрический вакуумный пинцет очень удобен, но мне все-таки не довелось его использовать. Короче говоря, если надумаете, то берите электрический.
Но, вернемся все-таки к нашей микросхеме. Крохотным толчком я убеждаюсь, что шарики действительно расплавились, и плавным движением вверх переворачиваю BGA микросхему. Если рядом много элементов, то идеально было бы использовать вакуумный электрический пинцет или пинцет с загнутыми губками.
Ура, мы сделали это! Теперь будем тренироваться запаивать ее обратно :-).
Вот и начинается самый сложный процесс – процесс накатывания шариков и запаивания микросхемы обратно. Если вы не забыли – это называется перекаткой. Для этого мы должны подготовить место на печатной плате. Убрать оттуда весь припой, что там остался. Смазываем все это дело флюсом:
и начинаем убирать оттуда весь припой с помощью старой доброй медной оплетки. Я бы посоветовал марку Goot wick. Эта медная оплетка себя очень хорошо зарекомендовала.
Если расстояние между шариками очень малое, то используют медную оплетку. Если расстояние большое, то некоторые ремонтники не прибегают к медной оплетке, а берут жирную каплю припоя и с помощью этой капельки собирают весь припой с пятачков. Процесс снятия припоя с пятачков BGA – очень тонкий процесс. Лучше всего на градусов 10-15 увеличить температуру жала паяльника. Бывает и такое, что медная оплетка не успевает прогреться и вырывает за собой пятачки. Будьте очень осторожны.
Дальше прыскаем туда Flux-off, чтобы очистить от нагара и лишнего флюса наше место под микросхему
и зашкуриваем с помощью простой зубной щетки, а еще лучше ватной палочкой, смоченной в Flux-Off.
Получилось как то так:

Если присмотреться, то видно, что некоторые пятачки я все таки оборвал (внизу микросхемы черные круги, вместо оловянных) Но! Не стоит расстраиваться, они, как говорится, холостые. То есть они не никак электрически не связаны с платой телефона и делаются просто для надежности крепления микросхемы.
Далее берем нашу BGAшку и убираем все лишние припойные шарики. В результате она должны выглядеть вот так:

И вот начинается самое интересный и сложный процесс – накатывание шаров на микросхему BGA. Кладем подготовленную микросхему на ценник:
Находим трафарет с таким же шагом шаров и закрепляем с помощью ценника микросхему снизу трафарета. Втираем в отверстия трафарета с помощью пальца паяльную пасту Solder Plus. Должно получиться как-то вот так:
Держим с помощью пинцета одной рукой пинцет, а в другой фен и начинаем жарить на температуре примерно 320 градусов на очень маленьком потоке всю площадь, где мы втирали пасту. У меня не получилось сразу в двух руках держать и фотоаппарат и фен и пинцет, поэтому фотографий получилось маловато.
Снимаем готовую микросхему с трафарета и смазываем чуть флюсом. Далее пригреваем феном до расплавления шаров. Это нам нужно, чтобы шарики ровнёхонько стали на свои места.
Смотрим, что у нас получилось в результате:

Блин, чуточку коряво. Одни шарики чуть больше, другие чуть меньше. Но все равно, это нисколько не помешает при запайке этой микросхемы обратно на плату.
Чуточку смазываем пятаки флюсом и ставим микросхему на родное место. Выравниваем края микросхемы с двух сторон по меткам. На фото ниже только одна метка. Другая метка напротив нее по диагонали.

И на очень маленьком воздушном потоке фена с температурой 350-360 градусов запаиваем нашу микрушку. При правильной запайке она должна сама нормально сесть по меткам, даже если мы чуток перекосили.
Замена чипа BGA своими руками в домашних условиях
Итак, в распоряжении домашнего мастера имеется материнская плата ноутбука, где в процессе диагностики обнаружена неисправная микросхема BGA поверхностного монтажа, в частности, чип одного из мостов компьютерной платы. Требуется демонтировать BGA микросхему поверхностного монтажа, а вместо демонтированного чипа необходимо установить другой – исправный компонент.
 Процесс замены неисправного чипа поверхностного монтажа на материнской плате ноутбука. Потребуется информация по извлечению платы из корпуса аппарата
Процесс замены неисправного чипа поверхностного монтажа на материнской плате ноутбука. Потребуется информация по извлечению платы из корпуса аппарата
Предварительно материнская плата вынимается из корпуса ноутбука, для чего следует обратиться к сервисной инструкции конкретного производителя планшетных компьютеров. В каждом отдельном случае процедура демонтажа материнской платы может кардинально отличаться.
Подготовка материнской платы к ремонту
Извлечённая печатная плата ноутбука устанавливается над инфракрасным кварцевым подогревателем с таким расчётом, чтобы максимальный поток тепла приходился на область месторасположения отпаиваемого чипа.
Следующий шаг – обработка микросхемы поверхностного монтажа специальным флюсом. Демонтируемый чип, как правило, прямоугольной (квадратной) формы, обрабатывается способом равномерного нанесения по периметру небольшого количества геле-образного флюса.
 Обработка демонтируемого чипа BGA специальным флюсом – обмазка геле-образным веществом четырёх сторон корпуса микросхемы, используя пластиковый шприц
Обработка демонтируемого чипа BGA специальным флюсом – обмазка геле-образным веществом четырёх сторон корпуса микросхемы, используя пластиковый шприц
Далее согласно технологической процедуре:
- включить инфракрасный нижний подогреватель,
- дождаться расплавления нанесённого флюса,
- при температуре 250-300ºC удалить угловые пластиковые фиксаторы чипа,
- после достижения температуры 300-325ºC задействовать паяльный фен.



Верхний прогрев микросхемы паяльным феном
Паяльным феном прогрев чипа поверхностного монтажа типа BGA выполняется по верхней стороне микросхемы. Если используется паяльная станция с регулятором температуры, параметры обычно выставляются на диапазон 350-400ºC. Равномерно направляя воздушный поток фена на область микросхемы, дожидаются полного расплава олова.
Момент полного расплава можно определить периодической проверкой состояния чипа. Как только чип начинает «покачиваться» на месте крепежа, пришло время применить инструмент вакуумной присоски.
Инструментом-присоской цепляются по центру корпуса микросхемы и попросту снимают чип с места установки. При полном расплаве олова эта операция не вызывает никаких трудностей.
Подготовка посадочной области микросхемы на плате
После удаления неисправной микросхемы поверхностного монтажа (BGA) следует подготовить место установки. Подготовка заключается в проведении «зачистки» контактных площадок под оловянные «шары» новой микросхемы. Для этой процедуры достаточно применить обычный паяльник с жалом – хорошо заточенным, имеющим ровные рабочие грани.
 Процедура зачистки посадочного места микросхемы поверхностного монтажа (BGA) с помощью обычного паяльника. Процесс занимает по времени не более одной-двух минут
Процедура зачистки посадочного места микросхемы поверхностного монтажа (BGA) с помощью обычного паяльника. Процесс занимает по времени не более одной-двух минут
Предварительно место «зачистки» обрабатывают небольшим количеством флюса под пайку BGA и далее аккуратно счищают жалом паяльника остатки олова.
Радиолюбители применяют разные способы для очистки, в том числе, вариант, когда используется кабельная оплётка. Но практика состоявшегося радиолюбителя показывает, вполне достаточно одного паяльника, терпения и аккуратности.
Установка и пайка нового исправного компонента
На следующем этапе подготовленный для замены чип BGA следует поместить на место демонтированной микросхемы. При этом необходимо соответствовать маркерам (линиям) на электронной плате, включая маркер «ключа», который указывает правильную позицию чипа согласно рабочим контактам.
Далее включается инфракрасный кварцевый подогреватель нижнего нагрева, плата прогревается до момента расплава флюса. Включают паяльный фен и выполняют прогрев верхней области микросхемы поверхностного монтажа до температуры 350-400ºC.
Вот, собственно и всё. Новая микросхема типа BGA установлена взамен неисправной. Материнская плата ноутбука готова к работе. Более подробно на видео ниже.
Видео мастер-класс отпайки (пайки) микросхемы BGA
Демонстрация видеороликом процесса демонтажа неисправного чипа с последующей установкой на замену исправной микросхемы BGA. Ремонт материнской платы ноутбука в домашних условиях со всеми подробностями:
Заключительный штрих по пайке чипов BGA
Как показывает текст выше, процедура замены (перепайки) микросхем поверхностного монтажа на различных электронных платах – задача вполне решаемая. Причём сделать эту работу можно в домашних условиях при условии наличия соответствующего инструмента. Владение навыками замены микросхем BGA открывает широкие просторы для организации собственного бизнеса по ремонту бытовой электронной техники.
Эффект «голова на подушке»

Доказано, что эффект «голова на подушке» – типичная проблема бессвинцовой паяльной пасты. Возникновение эффекта «голова на подушке» (на фотографии справа) зависит от производителя BGA-корпуса и химического состава пасты. Этот дефект возникает как следствие коробления компонента как после его изготовления (которое иногда называют компланарностью), так и зачастую коробления в процессе плавления. Если компонент смещается даже на несколько тысячных дюйма на этапе оплавления в печи, с большей долей вероятности не получится избежать эффекта «голова на подушке». Этот дефект считается дорогостоящим, поскольку в большинстве случаев его обнаруживают на более позднем этапе — в процессе эксплуатации. Дефект этого типа устраняется путем замены пасты, подбором соответствующего температурного профиля либо при возникновении деформации плоскости – наложением более толстого слоя пасты.
Отладка профиля при короблении плат
Один из способов оплавления, который помогает устранить эффект «голова на подушке», – применение профиля типа «нагрев – выдержка – пик». Для пайки применяется стандартный совместимый со сплавом профиль типа «нагрев – выдержка –пик», однако в начале стадии охлаждения необходимо контролировать ее скорость непосредственно перед достижением сплавом твердого состояния. Выдержка в течение 15–25 секунд при температуре на несколько градусов ниже температуры отверждения, помогает убрать коробление BGA-корпуса, погрузить корпус в расплавленную паяльную пасту и сформировать правильные интерметаллические соединения.

Вышеописанный профиль представляет собой стандартный профиль нагрева и выдержки с дополнительный стадией: тип профиля «нагрев – выдержка – пик – выдержка» (жирная линия).
Для чего бывает нужен ремонт BGA
Ремонт микросхем BGA на платах ноутбуков заключается в демонтаже чипа и восстановлении шариковых контактов (реболлинг) на его нижней поверхности. Это обязательно в тех случаях, когда микросхему планируется использовать повторно, потому что в процессе демонтажа контакты практически всегда повреждаются.
Реболлинг и пайка BGA — широко распространенные операции, поскольку позволяют восстанавливать работоспособность электроники ноутбука без замены платы целиком. И для клиента эта процедура обходится не так дорого, как, например, установка новой материнки, цена которой обычно составляет не менее половины стоимости ноутбука.
Необходимость в ремонте BGA возникает из-за нарушения паяных контактов микросхем с элементами платы. К подобному часто приводит:
- длительный перегрев ноутбука, который обычно является следствием скопления пыли внутри корпуса;
- перегрев из-за использования ноутбука в нештатном режиме при недостаточном охлаждении;
- частичный отвал BGA-микросхем после удара по корпусу или при падении ноутбука;
- заводской брак — плохой контакт присутствует изначально и проблема проявляется уже в первые недели или месяцы использования машины;
- попадание жидкости на электронные элементы ноутбука, что вызывает электрохимическую коррозию, в том числе и контактов микросхем.

При появлении дефекта пайки, нагрев микросхемы усиливается, из-за чего, вследствие большого перепада температур при остывании, контакты разрушаются еще сильнее. А это приводит к еще большему увеличению площади дефекта. Таким образом, нарушение паяного контакта BGA — прогрессирующая проблема. Кроме прочего, это приводит в негодность и саму микросхему.
Термовоздушная паяльная станция
Назначение станции Quick 861DE ESD Lead – пайка (демонтаж и монтаж) BGA микросхем и SMD компонентов. Преимущества этой станции:
- три режима памяти СН1, СН2, СН3;
- высокая производительность “по воздуху”, Quick 861DE подойдет для пайки плат и телефонов и ноутбуков;
- стабильность температуры.
Что бы можно улучшить в конструкции станции, это регулировка температуры не кнопками, а вращающимися регуляторами, как на Quick 857D (W)+.
![]()
Quick 861DE ESD Lead
Шаг 1 — Диагностика ноутбука

Анализируя заявленные неисправности и обстоятельства их возникновения, которые указал пользователь в момент запроса на обслуживание, обозначаются элементы или компоненты, которые могут вызвать такие симптомы. Когда подозрение падает на CPU или оперативную память, замена этих элементов для проверки их исправности, как правило, не является проблемой. Однако, когда вышел из строя чип BGA , такая замена не является возможной.
Диагностику поврежденного BGA можно сделать тремя способами:
- Прогрев BGA чипа горячим воздухом
BGA чип прогревается горячим воздухом определенной температуры. Используется строго определенная температура, чтобы предотвратить повреждение текстолита материнской платы. Эта процедура вызывает расширение микросфер под сердечником и работоспособность чипа временно восстанавливается .
Хотелось бы подчеркнуть, что этот метод используется только, чтобы подтвердить свой диагноз и не может рассматриваться в качестве полноценного ремонта BGA чипов. После охлаждения обычно возвращается неисправност ь системы. Но иногда это может быть через несколько дней или недель, поэтому очень важно иметь уверенность в сервисе, в котором вы собираетесь ремонтировать свой ноутбук.
Очень часто встречаются ситуации, когда недобросовестные сервисные центры просто прогревают видеочип , а заказчику говорят, что полностью перепаяли чип . При этом дают гарантию не больше месяца, а если неисправность повторяется, то просто делают еще один прогрев. А если прогрев не дает результата (довольно частая ситуация), говорят, что нужно менять материнскую плату ноутбука на новую, так как ремонт старой не возможен.
В моей мастерской имеется все необходимое оборудования для перепайки видеочипов , а гарантию я даю от 6 месяцев.
- Диагностика с помощью рентгеновского контроля.
Материнская плата извлекается из ноутбука и вставляется в камеру рентгеновского аппарата . Во время диагностики проверяется правильность соединения каждого шарика в системе.

- Основываясь на опыте
Работая в течение многих лет в области ремонта ноутбуков , и выполняя большое количество заказов на ремонт, я в состоянии заметить так называемые “волны” отказа той же системы BGA в различных марках и моделях ноутбуков. Срок службы или отказов одной и той же модели системы BGA похожи во всех ноутбуках, где они установлены.
Если я делаю большое количество замен конкретной модели северного моста в различных моделях ноутбуков, то я уже знаю на будущее, что даже в еще, казалось бы, работающем ноутбуке мост скоро может выйти из строя.
Шаг 2 — демонтаж BGA

Когда уже известно, какая система BGA повреждена, приступаю к демонтажу BGA чипа из платы. При этом материнская плата устанавливается в инфракрасную паяльную станцию и с помощью программного обеспечения выбирается подходящий термопрофиль. Для мониторинга термопрофиля производится установка одной или нескольких термопар. Данный процесс полностью автоматизирован.
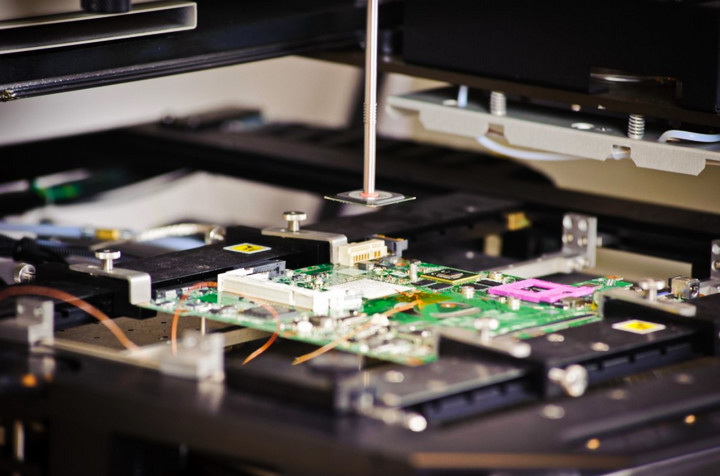
Шаг 3 — Очистка от припоя и флюса
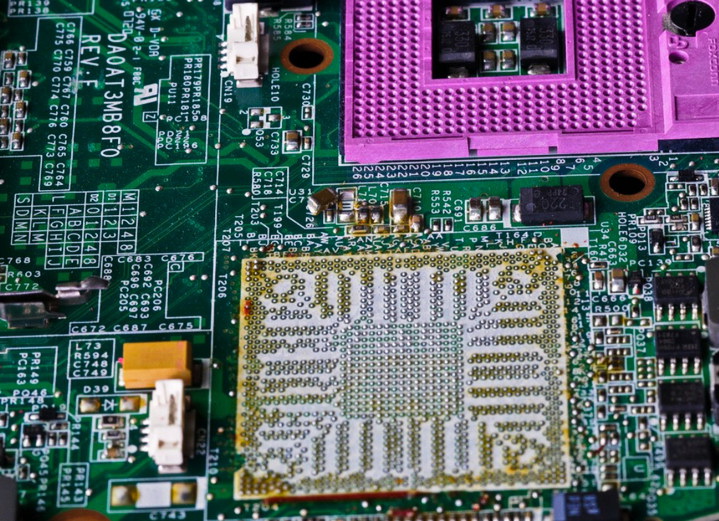
На следующем этапе производиться тщательная чистка от старого припоя и остатков флюса с материнской платы и самого чипа.
Шаг 4 — Подготовка нового BGA чипа
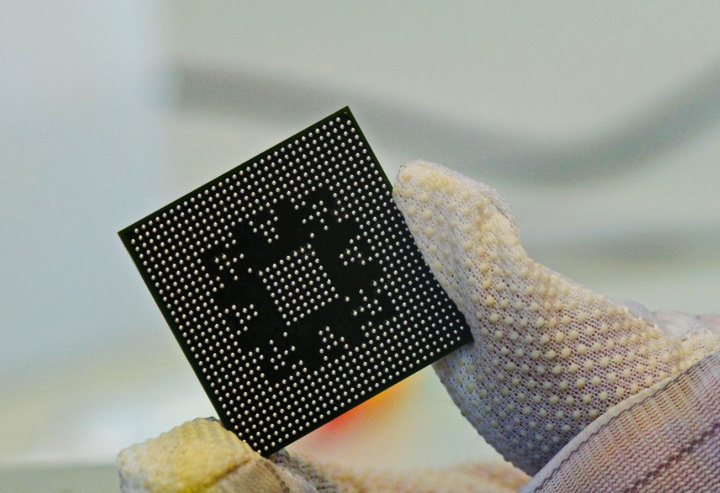
Если делается реболлинг чипа , то к нему крепится трафарет и заполняется шариками. Видеочип с трафаретом нагревается на паяльной станции до оплавления шариков. В случае, если делается замена видеочипа (самый рекомендованный, но и затратный способ ремонта), то обычно шары там уже накатаны .
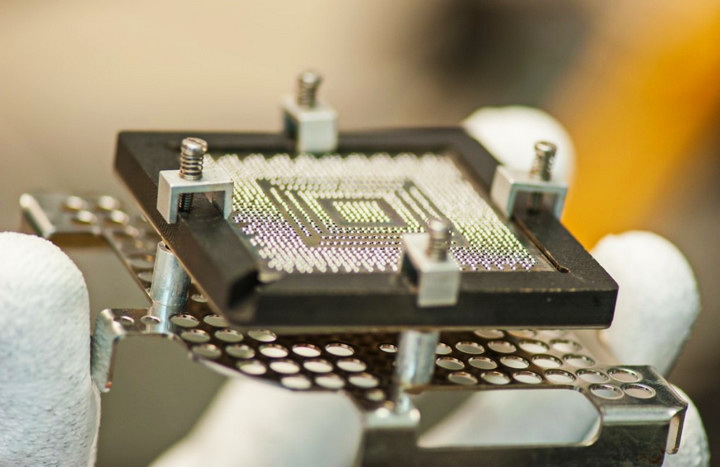
Шаг 5 — BGA монтаж, припайка чипа к материнской плате
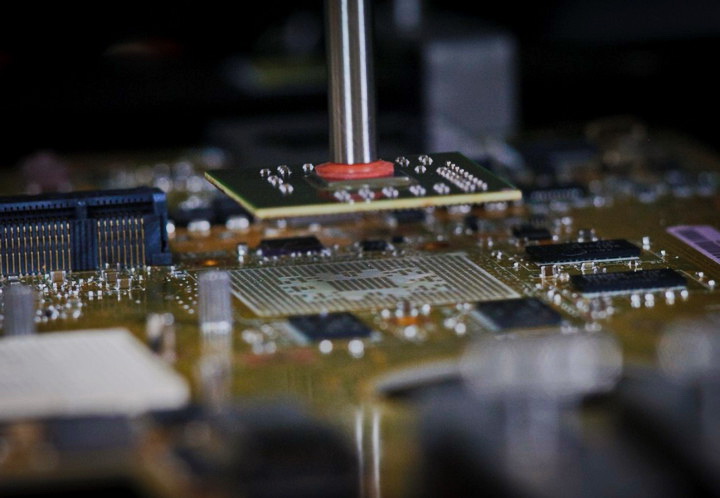
Для BGA монтажа также используется инфракрасная паяльная станция. Выбирается соответствующий профиль пайки для новой компоновки, позиционируется новый чип по отношению к материнской плате и выполняется припайка чипа . Процесс БГА монтажа выполняется автоматически.
Шаг 6 — правильное охлаждение и очистка от флюса

После монтажа системы материнская плата должна в соответствующих условиях потерять тепло , в противном случае напряжения, вызванные быстрой потерей тепла, могут привести к растрескиванию и потери путей соединения на печатной плате. Процесс постепенного охлаждения тоже происходит автоматически на паяльной станции.
По завершении процесса правильного охлаждения станция дает звуковой сигнал. Затем удаляются все следы флюса в непосредственной близости от BGA. После правильного компонентного ремонта материнской платы отсутствуют какие-либо признаки вмешательства.
Шаг 7 — обратная сборка ноутбука после ремонта материнской платы

После ремонта материнской платы ноутбука наносится новая термопаста на чип . При необходимости, вентилятор системы охлаждения ноутбука очищается и смазывается, чтобы максимизировать охлаждение во время работы.
Шаг 8 — Тестирование под нагрузкой и проверка работоспособности ноутбука
Перед тем как отремонтированный ноутбук будет отдан в руки владельца, на нем производится в общей сложности 52 теста контроля качества , которые должны обнаружить возможные ошибки при ремонте или дополнительные проблемы с эффективностью.
Зачем нужен ремонт BGA SMD микросхем и чипов?

BGA представляют собой шарики, состоящие из припоя, местами размещения которых служат контактные площадки на задних поверхностях микросхем. Такие микросхемы являются компонентами SMD — печатных плат. Эти шарики широко используются в сфере микроэлектроники — на платах смартфонов, материнских платах ПК, чипах фотоаппаратов.
Ремонт BGA-подошвы на чипах либо её замена является сложным техническим процессом, который подразумевает наличие определённых познаний, опыта, навыков выполнения некоторых действий с ювелирной точностью. Отремонтировать качественно микросхемы невозможно при отсутствии специализированного оснащения и необходимых расходников. Безусловно, можно попытаться выполнить эту работу самостоятельно с помощью подручных средств, однако это приведёт лишь к усугублению проблемы и к выходу из строя всей платы, что, в свою очередь, вызовет увеличение итоговой цены ремонта устройства.
Неисправности BGA-подошвы могут появляться по причине производственного брака, сбоев в системе охлаждения, запыления устройства. В случае пренебрежения периодической чисткой устройств от пыли, а также заменой термопасты тоже возможны проблемы с микросхемами.
Существует несколько способов устранения неисправности BGA-подошвы на чипах. Можно демонтировать и затем установить обратно чип, восстановив шарики припоя, либо совершить замену микросхемы. Второй способ является дорогостоящим, по этой причине в любой ситуации, когда возможно «спасение» микросхемы, мы выполняем реболлинг BGA-подошвы.
Ремонт чипов является довольно сложным и подразумевает применение специализированного оборудования, а также наличие определённой квалификации у мастеров. Именно такие профессионалы работают в нашей компании, поэтому нам по силам быстро выполнить ремонт моста либо видеокарты. Кроме того, мы предоставляем услугу доставки неисправных устройств нашим курьером в наш центр, в котором будет выполнена бесплатная диагностика. Также мы объясним подробно этапы предстоящего ремонта, а затем озвучим его точную цену.
Реболлинг BGA

Ремонт BGA SMD микросхем
В июле 2017 к нам сервисный центр приносили ноутбук HP Probook 4525s, почитайте о процессе его ремонта в нашем блоге.
Также вы можете посмотреть видео о ремонте данной модели ноутбука с перепайкой BGA чипа на материнскую плату.
BGA под прицелом ЭРСАСКОПа
Зримые плоды новаторства ERSA
В конкурентном мире производителей электронной техники возможность видеть, использовать визуальную информацию для контроля качества является стратегическим преимуществом. Именно поэтому «знаковым» этапом экспансии фирмы ERSA, крупнейшего поставщика паяльного оборудования, стала не очередная паяльная машина, а принципиально новая оптическая система контроля качества пайки BGA. Презентация ERSASCOPE-3000 недавно состоялась на всемирной выставке технологического оборудования Productronica-99. В статье изложена идейная основа подхода и приведены примеры уникальных снимков из-под BGA, получение которых стало реальностью.
На BGA сошелся клином.
Глобальная тенденция перехода к BGA — поверхностно-монтируемым корпусам с матричным расположением плавких выводов — уже ощущается и в России. Первыми с BGA столкнулись сервисные центры по ремонту зарубежной связной и компьютерной техники, а также отряд отечественных разработчиков, использующих новейшую элементную базу. В печати (напр. «Экспресс-Электроника» № 4’99г.) уже обсуждались особенности BGA и инструмента ERSA для паяльно-ремонтных работ с этими корпусами. Между тем, узким местом на пути массового внедрения BGA остается выходной контроль качества пайки, ибо выводы BGA расположены в недоступной для визуального наблюдения зоне, и сделать заключение о качестве пайки не так-то просто.
Контроль качества пайки BGA
До сих пор рентгеновский контроль был единственным методом неразрушающего контроля качества пайки BGA. Анализ рентгеновских снимков, производимых в проекции корпуса BGA на печатную плату, позволяет выявлять широкий спектр типовых дефектов, могущих образоваться в ходе пайки, как то: межвыводные перемычки, смещения, пустоты. Вместе с тем, рентген неэффективен для обнаружения «холодных паек», микротрещин между выводами BGA и контактными площадками и еще ряда дефектов. Только один пример: поскольку силами поверхностного натяжения уже на начальной фазе пайки сферические выводы PBGA (или CSP) самоцентрируются по контактным площадкам, то рентгеновская проекция «холодной пайки» может выглядеть практически безукоризненно! Наконец, рентгеновское оборудование слишком дорого, чтобы стать широко доступным инструментом для повседневного контроля качества.
К методам неразрушающего контроля изделий с BGA традиционно относится и функциональное тестирование. Увы, функциональный тест «холодной пайки» может выполняться с тем же успешным результатом, что и для надежного паяного соединения: электрический контакт выводов BGA с проводниками на печатной плате имеет место в обоих случаях, хотя в первом он и недолговечен. Таким образом, основываясь на результатах даже двух типов неразрушающих тестов — функционального и рентгеновского, — сложно сделать вывод о качестве пайки в смысле ее долговременной прочности.

В классе методов разрушающего контроля применяются два: исследование внутренней структуры выводов BGA после пайки (в срезе) под электронным микроскопом и механический тест на растяжение (отрыв). Структурный анализ имеет целью идентифицировать результат физико-химических процессов пайки в диффузионных слоях контактирующих металлов: ведь именно этими слоями определяется долговременная прочность паяного соединения. При «холодной пайке» тепла не хватает для образования достаточно глубоких диффузионных слоев, при избыточной же температуре пайки они становятся слишком глубокими и «рыхлыми». В обоих случаях неправильный температурный профиль пайки влечет резкое уменьшение прочности паяного соединения. Тест на растяжение позволяет оценить прочность пайки как интегрального показателя качества. Если технология пайки была соблюдена безупречно, то паяное соединение между выводом BGA и контактной площадкой оказывается прочнее соединения контактной площадки с платой и, как следствие, при выполнении теста происходит обрыв контактной площадки, а не вывода BGA. Очевидно, методы разрушающего контроля используются лишь на ограниченной выборке изделий и имеют экономически обусловленный предел.
Необходимым и эффективным дополнением методов неразрушающего контроля пайки BGA является визуальная (оптическая) инспекция. Этот принципиальный тезис побудил фирму ERSA к разработке первой в мире системы контроля, обеспечивающей возможность визуальной инспекции паяных выводов под корпусом компонента. Система ERSASCOPE-3000 значительно дешевле рентгеновских средств контроля, безопасна, компактна и проста в использовании. Применение ERSASCOPE-3000 может помочь там, где рентгеновский контроль бессилен, а систематическое применение разрушающих методов невозможно по экономическим соображениям. На чем же, по мнению специалистов ERSA, базируется возможность визуального контроля качества пайки BGA?
Идейная основа ERSASCOPE
При корректном соблюдении технологии пайки все выводы BGA трансформируются в следующем порядке.
Состояние A. Перед началом процесса пайки сферические выводы BGA (Sn63Pb37) позиционированы по контактным площадкам печатной платы. Нижняя плоскость корпуса BGA параллельна плате (в конкретном примере на рис. 1 она отстоит от платы на высоту 1,0 мм; для разных корпусов высота, очевидно, различна). Форма выводов BGA — правильная сферическая, поверхность гладкая, слегка матовая.

Рис. 1. Фаза А процесса пайки и состояние выводов BGA
Состояние B. Процесс оплавления выводов начинается при температуре 183°C. Под действием сил гравитации происходит первичное «оседание» BGA (рис. 2): расстояние между корпусом и платой сокращается до 0,8 мм, форма выводов становится бочкообразной, а поверхность выводов тускнеет, оставаясь гладкой.
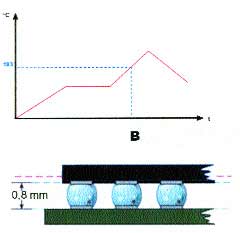
Рис. 2. Фаза В процесса пайки и состояние выводов BGA
Состояние C. По достижении пиковой температуры пайки происходит полное оплавление выводов и смачивание контактных площадок платы припоем. Происходит вторичное «оседание» BGA (рис. 3): высота выводов еще раз уменьшается (в примере до 0,5 мм), результирующая форма выводов, поддерживаемая силами поверхностного натяжения, — сплющенная эллиптическая. Поверхность выводов — гладкая блестящая.
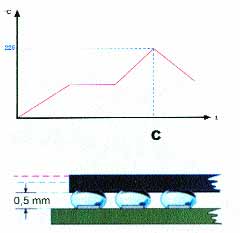
Рис. 3. Фаза С процесса пайки и состояние выводов BGA
Важнейшими признаками при оценке качества паяного соединения являются:
- количество припоя в зоне паяного соединения;
- форма мениска (соответствие технологическим стандартам);
- состояние поверхности выводов (текстура, однородность, гладкость, цвет, блеск);
- аномалии (например, остатки флюса).
Все признаки важны для контроля качества пайки, но именно состояние поверхности выводов дает наибольшую информацию о механической прочности соединения, ибо помогает сделать заключение об условиях формирования интерметаллического диффузионного слоя в процессе пайки. Визуально различимы
- неоднородная или пористая поверхность выводов, царапины;
- деформация формы (асимметричность, впадины и выпуклости, искривления);
- микротрещины;
- изменения цвета;
- микрокапли и брызги припоя;
- остатки флюса;
- посторонние включения (шлак/окалина).
Идея ERSASCOPE-3000 проста: заглянув под корпус BGA, проконтролировать правильность итоговой формы выводов, копланарность и отсутствие перемычек. У выводов, ближайших к граням корпуса BGA, следует рассмотреть также поверхность. Удается проанализировать и мениски, если при пайке была использована паяльная паста (это касается прежде всего керамических BGA). На данной нехитрой идее с мощным техническим воплощением и базируется ERSASCOPE-3000.
Как устроен ERSASCOPE
Система ERSASCOPE-3000 (рис. 4) включает оптическую часть на штативе и компьютерную часть с устройством отображения. Изделие (печатная плата) закрепляется в штативе так, что перемещаемые вручную элементы оптической системы с высоким разрешением «охватывают» корпус BGA (рис. 5). С одной стороны корпуса располагается мощный (150 Вт) миниатюрный источник света с волоконной оптикой, с противоположной стороны — головка оптического приемника с регулируемым фокусным расстоянием (0–55 мм).

Рис. 4. ERSASCOPE-3000
Минимальный зазор между корпусом BGA и печатной платой, при котором система работает устойчиво, составляет всего 0,05 мм. Максимальные линейные размеры корпуса BGA, для которых мощность подсветки достаточна, — 50 мм. Изображение с приемной оптической головки передается в компьютер для обработки и на монитор (с увеличением до 350 раз) для человеко-машинного анализа. Отпускная цена системы такова, что для многих западных производств (а в перспективе — и некоторых российских) она является весьма разумной с учетом открывающихся возможностей массового выходного контроля изделий, содержащих BGA.

Рис. 5. Рабочее положение оптических элементов
Применения ERSASCOPE
Следует отметить, что оптическая инспекция качества пайки может быть применена не только в отношении корпусов BGA и им подобных, но также для корпусов PLCC с J-образными выводами и QFP (с внутренней стороны через просвет между корпусом и линейкой выводов). В модификации MAGNISCOPE подвижная оптическая головка с подсветкой позволяет анализировать миниатюрные объекты сверху или под любым углом до 180° при увеличении их с кратностью до 350 с отображением на мониторе. Измерение, архивирование, документирование и другие прелести компьютерной обработки обеспечиваются программным пакетом ImageDoc. Примеры областей применения ERSASCOPE и объектов анализа:
- точность установки компонентов перед пайкой;
- качество пайки BGA и других SMD-компонентов;
- качество (доза и форма) нанесения паяльной пасты;
- качество трафарета;
- качество металлизации отверстий на печатной плате;
- целостность защитного покрытия платы;
- качество микросварки;
- применения в других отраслях (например, техническая эндоскопия металлоизделий).
Фоторепортаж из-под BGA
На основе кадров (рис. 4–12) можно получить начальное представление о типе изображений, анализируемых менеджером по контролю качества при использовании системы ERSASCOPE-3000 в полноэкранном варианте на высококачественном мониторе.



